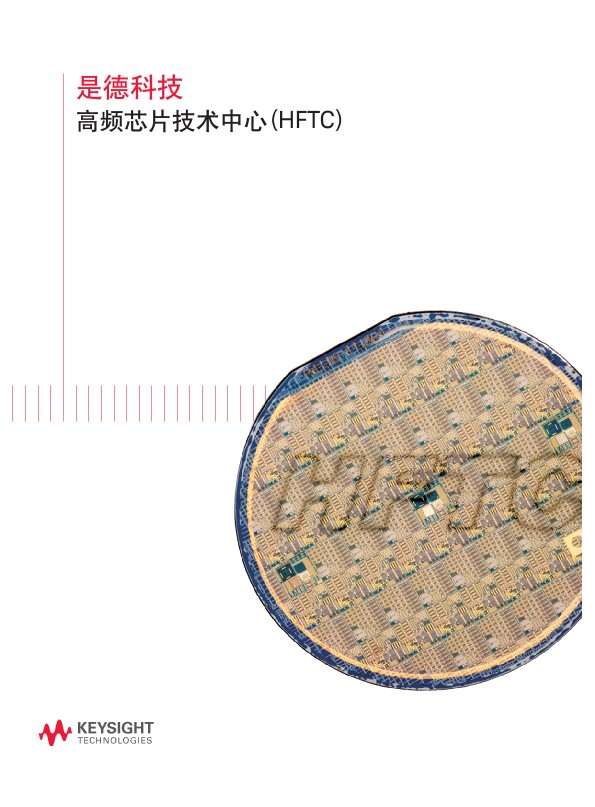
高频芯片技术中心 (HFTC)
手册
技术资源
除了内部材料生长和使用,高频芯片技术中心也会经常应用商业供应商的创新半导体材料。许多此类材料属于技术中心与战略供应商的合作开发成果。
高频芯片技术中心还会应用晶圆代工厂的技术,以增强是德科技仪器的竞争力,同时补充内部能力。这些技术包括氮化镓、极高性能pHEMTs、MEMS开关和先进互连等。是德科技高频芯片技术中心 (HFTC) 位于美国加利福尼亚州圣罗莎市,主要负责研发、生产、封测世界领先的定制集成电路,是确保是德科技能够为客户提供最尖端测量解决方案的基础。高频芯片技术中心集合了先进的复合半导体工艺产线 (1.3 万平方英尺 ,class-100净化级) 以及全球高端设计、建模、测量和精密加工专家,能够快速创新并提供全球顶尖的高频芯片技术,为卓越的测量产品开发提供基础。
HFTC拥有的的半导体技术:
- 锑砷化镓/磷化铟 DHBT (发射极沟道宽度1 μm, 截止频率200 GHz), 用于仪器前端的通用数字、模拟及信号处理前端芯片
- 磷化铟镓/砷化镓 HBT (发射极沟道宽度2 μm, 截止频率70 GHz), 用于通用数字、模拟芯片
- 固态开关 (超快速切换), 50 GHz 开关及衰减器
- 砷化镓结及肖特基二极管工艺 (基于磷化铟镓/砷化镓 HBT 平台), 用于信号处理、混频器、倍频器和开关
- 砷化镓/砷化铟镓/砷化铝镓 pHEMT (i-line 及电子束光刻, 栅极长度 250 nm~120 nm, 截止频率 60~90 GHz), 用于毫米波低噪放、功放及开关
- 砷化镓 FET (i-line 光刻, 栅极长度 350 nm、截止频率30 GHz),用于微波功率放大器和开关。
- 砷化镓热电偶器件 (湿法刻蚀), 功率计的功率传感器。
- 下一代新兴工艺的开发。
技术资源
除了内部材料生长和使用,高频芯片技术中心也会经常应用商业供应商的创新半导体材料。许多此类材料属于技术中心与战略供应商的合作开发成果。高频芯片技术中心还会应用晶圆代工厂的技术,以增强是德科技仪器的竞争力,同时补充内部能力。这些技术包括氮化镓、极高性能pHEMTs、MEMS开关和先进互连等。
材料生长
是德科技仪器出色的性能源于应用III-V族半导体材料构建的高速/高频集成电路,这是高频芯片技术中心的核心能力。
分子束外延
分子束外延 (MBE) 可以提供精密的先进 III-V 半导体生长方法。周期表 III 族 (镓、铟和铝) 和 V 族 (砷、锑) 元素可以化合生成:砷化镓 (GaAs)、砷化铝 (AlAs)、砷化铟镓 (InGaAs)、砷铟铝镓(InAlGaAs) 和锑砷化镓 (GaAsSb) 半导体。上述 III-V 化合半导体中,载流子速度可能较高,设计能带隙可以优化载流子导带和载流子禁带。
MBE 生长需要超高真空 (10-10托) 环境,以确保纯净分子束传播不会受到干扰。加热元素分子可以生成分子束,然后在加热砷化镓或磷化铟基板上积淀。外延或结晶生长需要 450~600 °C 的基板温度,生长速度约2.8 Å/s。独立快门可以控制分子束,能够生成单原子层晶体。
使用硅、铍或碳等掺杂剂可以生成 p 型或 n 型半导体特性。技术中心的分子束外延功能包括:
- 一台多晶圆Veeco Gen200 (砷)
- 一台多晶圆Veeco Gen200 (砷、锑), 支持原位氢等离子体表面处理功能
材料表征工具
高频芯片技术中心配备丰富的表征工具以支持材料生长:
- Rigaku SmartLab X射线衍射、反射
- Nanometrics RPM-blue生产光致发光
- 超高灵敏度研发光致发光和光调制反射
- Lehighton非接触式电导制图
- 77K和300K霍尔测量
- 表面探测表征
- 相差光学显微镜
光刻
光刻包括基于尼康步进光刻机的投影光刻、接触式光刻和电子束光刻。除了上述曝光工具,光刻工艺包括光刻胶炉、涂胶/显影跟踪与计量工具。综合的工具支持移除和刻蚀掩膜工艺,适合平面和非平面表面,支持500nm至30μm的抗蚀剂厚度和120nm至100μm的临界尺寸(CD)。详细功能如下:
- Nikon NSR-2205i12D i-line (365nm)步进光刻机和TEL Mark Vz晶圆光刻胶处理跟踪
- 350nm分辨率
- ≤65nm <x>+3σ对迭
- 移除和刻蚀掩膜工艺
- JEOL JBX-6000FS电子束系统
- 波束直径5至100nm, 50KV
- ≤60nm <x>+2σ对迭
- 120nm pHEMT栅极移除
- 每次自动加载多达12个晶圆盒
- EVG620 自动双面掩膜对准系统和C&DP9000晶圆抗蚀剂涂胶和显影跟踪
- 背面通孔、背面划线和芯片ID处理
- 背面显微镜对准、红外直通晶圆校准和标准上部校准功能
- 高达30μm背面通孔刻蚀掩膜抗蚀剂厚度, 可选涂层掩膜。接触模式为1μm CD
干法刻蚀
干法刻蚀功能支持广泛的工具和工艺。使用光刻胶、金属和电介质掩膜,刻蚀CD范围为120 nm至60μm,刻蚀深度范围50nm至100μm。刻蚀材料包括但不限于: GaAs、InP、InGaP、InAlAs、GaAs- Sb、SiO2、Si3N4、BCB、W和Ti/Pt/Au。详细功能描述如下:
- 双SPTS高密度等离子(HDP)刻蚀器
- 静电卡盘可以实现精确温度控制
- 高温刻蚀功能
- 激光端点提供精确的刻蚀终止以及低曝光
- 三台SPTS Omega通用RIE刻蚀器
- 单台SPTS Omega RIE刻蚀器, 用于提供深入的砷化镓刻蚀, 例如使用机械夹股夹盘刻蚀背面通孔
- 两个Oxford PlasmaLab100群组工具, 配有多个刻蚀室, 支持高温运行,以及光发射和激光端点功能
- 一个IPE RIE刻蚀工具, 支持手动加载, 能够适应异形基板
- VEECO 离子减薄系统可以分别提供3μm和1.5μm线束以及2μm间隔和1μm厚金喷镀
淀积
淀积工艺可以通过溅射淀积、电子束蒸镀、丝热蒸镀、等离子体增强化学气相淀积 (PECVD)、旋涂涂层和电镀等工艺支持薄膜应用,覆盖厚度 1 至7 μm 的高导金属、电阻薄膜以及绝缘、平坦化和绝缘化介质。
- CVC 和三个 TES 溅射淀积系统, 配有原位离子源
- 淀积 Ti、Au、Ta2N、WSiNx、W和TiW
- CHA 电子束蒸镀器, 配有原位离子减薄仪, 可以淀积 Ti、Pt、Au、Ni、Ge或Au/Ge
- 一台Temescal BJD1800电子束蒸镀器, 用于Ti、Pt和Au淀积
- 三台Temescal长冲程电子束蒸镀器,其中两台配有原位离子减薄仪, 用于Ti、Pt、Au、Ni、Ge和Mo淀积
- 三个SPTS Delta PECVD系统
- 负载锁定、盒间操作
- 50至10,000埃SiNx和SiOx膜
- 厚度均匀性<5%
- 淀积前等离子体表面整理
- American Plating Systems镀金设备
- 氰化物镀金解决方案
- 脉冲电镀, 确保背面通孔获得良好的同形覆盖
- 选择性背面电镀
- C&D P9000群组系统与Solitec 820系列可以跟踪层间介质, 并且能够借助热板烘焙机和温控气炉予以加固
- HD Microsystems polyimide 1至2μm厚
- Dow Cyclotene (BCB) 2至7μm厚
需要更多信息,请下载是德科技高频技术中心(HFTC)手册。